Copyright HGLaser Engineering Co,.Ltd. All Rights Reserver.
超大規模集積回路製造技術、新型薄膜トランジスタ表示技術と大面積OLED表示技術の成熟と規模化に伴い、レーザーアニーリング技術は伝統的な炉管アニーリング、急速熱アニーリング、スパイクアニーリング、フラッシュアニーリングに取って代わり、新世代の主流アニーリング技術となっている。
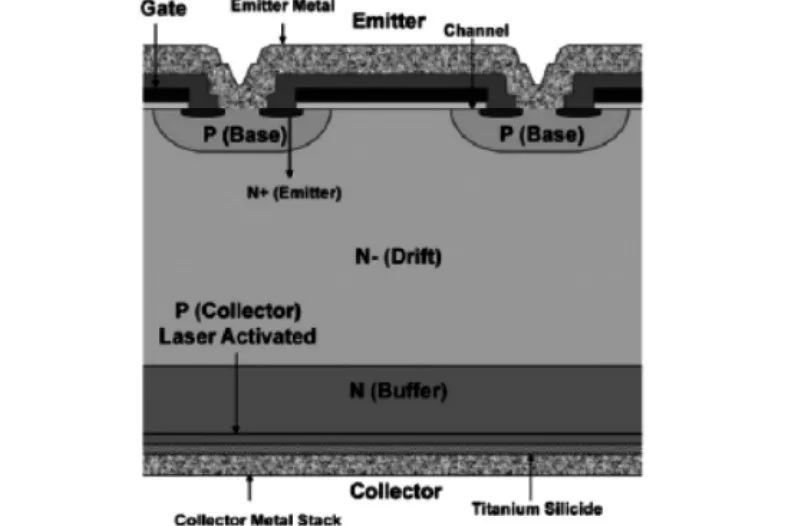
1975年に旧ソ連の科学者Gerasi-menkoがレーザーアニーリングの研究を始めて以来、それから数年間、研究者はレーザーアニーリングのメカニズムの研究に深い興味を持っていた。レーザーアニーリングの顕著な特徴は、超短時間(数十〜数百ナノ秒オーダー)で高エネルギー密度のレーザー照射(いくつかのJ/cm 2)をアニーリングサンプルの小さな領域に投射し、サンプル表面の材料を溶融させ、その後の降温過程で自然に溶融層液相エピタキシャル成長させ、溶融層の結晶構造を再構成することである。
結晶を再構成する過程で、イオン注入による格子損傷が解消され、ドーピングされた不純物が高温で拡散し再分布し、不純物原子が結晶に溶解し、活性化されて正孔または電子が放出される。
レーザ焼鈍技術は主にイオン注入損傷を修復するための半導体材料、特にシリコンに用いられ始めた。従来の加熱焼鈍技術は、ワーク全体を真空炉に入れ、一定の温度(300° ;~1200℃)で10~60 min保温焼鈍するものであった。
集積回路におけるレーザーアニール技術の応用は、主に以下の3つの方面にある:(1)半導体装置の電極(ソース、ドレイン、ゲート)をアニールし、金属化してオーミック接触を形成する、(2)集積回路内部への接続アニール、(3)メモリ、NEMSなどの3 D構造をアニールする。
MOSFET、IGBTなどのパワーデバイスには垂直な構造があり、動作中には垂直方向の電流があり、背面電極はオーミックコンタクトまたはエミッタとして使用される。この背面電極はレーザアニーリング技術を用いて容易に得ることができる。IGBTコレクタ構造は2つのドーピング領域を含む:P型の表面コレクタ、埋め込みN型フィールドカットオフ層、
Ti金属層の厚さの合理的な選択により、反転防止膜と熱吸収層の層にすることができ、それによりレーザーアニールの効率を高め、より多くの不純物を活性化させ、より高いドーピング濃度を得ることができる。そのため、処理時にTiを下地として使用することが多い。
あなたも興味があるかもしれません:
-
info@hglaser.com
-
+86 27 8718 0225
-

-

